


Продукты шаблона pam-xiamen состоят из кристаллических слоев нитрида галлия (гана), нитрида алюминия (aln), нитрида алюмини галлия (algan) и нитрида галлия индия (ingan), которые осаждаются на сапфировые подложки, кремниевый карбид или кремний. Продукты шаблона pam-xiamen позволяют сократить время цикла эпитаксии на 20-50% и слоты более высокого ка5

pam-xiamen установила технологию изготовления для автономной (галлиево-нитридной) пластины подложки gan, которая предназначена для uhb-led и ld. выращенный методом гидридной парофазной эпитаксии (hvpe), наш газовый субстрат имеет низкую плотность дефектов.5

pwam разрабатывает и производит составные полупроводниковые подложки - кристалл арсенида галлия и вафли. Мы использовали передовые технологии выращивания кристаллов, технологию вертикальной градиентной заморозки (vgf) и технологии обработки валов gaas, создали производственную линию от роста кристаллов, резки, шлифования до обработки полировки и по5
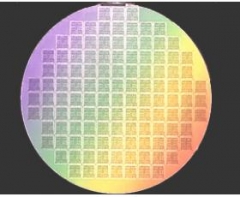
мы предоставляем индивидуальную экситаксию тонкой пленки (карбид кремния) на подложках 6h или 4h для разработки устройств из карбида кремния. sic epi wafer в основном используется для диодов Шоттки, полупроводниковых полевых транзисторов с металлическим оксидом, транзисторов с полевым эффектом перехода, биполярных транзисторов, тиристоров, gto и из5

pam-xiamen предлагает полупроводниковые пластины из карбида кремния, 6h sic и 4h sic в разных классах качества для исследователя и промышленными производителями. мы разработали технологию выращивания кристаллов sic и технологию обработки кристаллов sic crystal, установила производственную линию для изготовителя sic-субстрата, который применяется в 5

Эпитаксиальная пластина на основе ламината pam-xiamen's (галлиевого нитрида) предназначена для применения в ультра-высокой яркости синего и зеленого светодиодов (светодиодных) и лазерных диодов (ld).5

нитрид галлия (gan) (транзисторы с высокой электронной подвижностью) являются следующим поколением высокочастотной транзисторной технологии. Благодаря технологии gan, pam-xiamen теперь предлагает epig wafer algan / gan на сапфире или кремнии и шаблон algan / gan на сапфире ,5

вы можете получить нашу бесплатную техническую услугу от запроса до послепродажного обслуживания на основе нашего 25+ опыта в полупроводниковой линии.
наша цель - удовлетворить все ваши требования, независимо от того, как небольшие заказы а также как сложные вопросы они могут поддерживать устойчивый и прибыльный рост для каждого клиента через наши квалифицированные продукты и удовлетворительные услуги.5
с более чем 25 + лет опыт в области составных полупроводниковых материалов и экспортного бизнеса наша команда может заверить вас, что мы сможем понять ваши требования и профессионально работать с вашим проектом.5
качество - наш первый приоритет. pam-xiamen был iso9001: 2008 , владеет и делит четыре современных фасада, которые могут предоставить довольно большой ассортимент квалифицированных продуктов для удовлетворения различных потребностей наших клиентов, и каждый заказ должен быть обработан через нашу стр5
















Кристаллы поли -Si в основном используются в солнечных элементах из-за их низкой стоимости. Здесь зоны чувствительности к длинам волн в солнечном свете должны быть расширены для повышения инженерной эффективности солнечных элементов.. Пленки соединений полупроводников группы IV, например пленки Si (Ge), легированные атомами C, Ge (C, Si) и/или Sn с содержанием нескольких %, на подложке Si или Ge были идентифицированы как потенциальные решения этой технической проблемы. проблема. В этом исследовании мы рассчитали энергию образования каждой атомной конфигурации атомов C, Ge и Sn в Si с использованием теории функционала плотности. Метод «Хаконива», предложенный Kamiyama et al. [Materials Science in Semiconductor Processing, 43, 209 (2016)] применяли к сверхъячейке из 64 атомов Si, включающей до трех атомов C, Ge и/или Sn (до 4,56%), чтобы получить соотношение каждой атомной конфигурации и среднее значение ширины запрещенной зоны Si. Для получения более надежных запрещенных зон Si использо...
прочитайте большеСоединение пластин GaAs с использованием обработки сульфидом аммония (NH4)2S исследовано для различных структур. Изучено влияние угла среза пластины на электропроводность устройств с солнечными элементами AIIIBV, использующих структуры с пластинами n-GaAs/n-GaAs. Рентгеновская дифракция высокого разрешения используется для подтверждения разориентации склеенных образцов. Кроме того, мы сравниваем электрические свойства эпитаксиально выращенных pn-переходов на GaAs со структурами, связанными с пластинами n-GaAs/p-GaAs. Просвечивающая электронная микроскопия высокого разрешения (HRTEM) и сканирующая просвечивающая электронная микроскопия(STEM) используются для сравнения морфологии интерфейса в диапазоне относительных разориентаций после 600 {знак градуса} C RTP. Соотношение хорошо связанных кристаллических областей и аморфных оксидных включений одинаково для всех связанных образцов, что указывает на то, что степень разориентации не влияет на уровень рекристаллизации интерфейса при высоких...
прочитайте большеОптическое пропускание, температурная зависимость фотолюминесценции (ФЛ) и комбинационное рассеяние пористого SiC, полученного из 6H-SiC p -типа, сравниваются с таковыми из объемного 6H-SiC p -типа .. В то время как спектр пропускания объемного SiC при комнатной температуре показывает относительно острый край, соответствующий его ширине запрещенной зоны при 3,03 эВ, край пропускания пористого SiC (PSC) слишком широк, чтобы определить его ширину запрещенной зоны. Считается, что этот широкий край может быть связан с поверхностными состояниями в PSC. При комнатной температуре ФЛ от PSC в 20 раз сильнее, чем от объемного SiC. Спектр PL PSC практически не зависит от температуры. Относительная интенсивность пиков рамановского рассеяния от PSC в значительной степени не зависит от конфигурации поляризации, в отличие от пиков от объемного SiC, что предполагает, что локальный порядок является довольно случайным. Источник: IOPscience Для получения дополнительной информации посетите на...
прочитайте большеОптическое пропускание, температурная зависимость фотолюминесценции (ФЛ) и комбинационное рассеяние пористого SiC, полученного из 6H-SiC p -типа, сравниваются с таковыми из объемного 6H-SiC p -типа .. В то время как спектр пропускания объемного SiC при комнатной температуре показывает относительно острый край, соответствующий его ширине запрещенной зоны при 3,03 эВ, край пропускания пористого SiC (PSC) слишком широк, чтобы определить его ширину запрещенной зоны. Считается, что этот широкий край может быть связан с поверхностными состояниями в PSC. При комнатной температуре ФЛ от PSC в 20 раз сильнее, чем от объемного SiC. Спектр PL PSC практически не зависит от температуры. Относительная интенсивность пиков рамановского рассеяния от PSC в значительной степени не зависит от конфигурации поляризации, в отличие от пиков от объемного SiC, что предполагает, что локальный порядок является довольно случайным. Источник: IOPscience Для получения дополнительной информации посетите на...
прочитайте большеВ данной работе описан метод отжига кристалла CdZnTe . В качестве источников отжига используются чистые металлы Cd и Zn, которые одновременно обеспечивают точное равновесное парциальное давление Cd и Zn для CdZnTe при определенной температуре. Характеристики показывают, что однородность значительно улучшается, а плотность дефектов уменьшается более чем на порядок, и, таким образом, структурные, оптические и электрические свойства кристалла CdZnTe, очевидно, улучшаются в результате этого отжига. Исследование температурной зависимости качества CdZnTe после отжига показывает, что 1073 К является предпочтительной температурой отжига для CdZnTe. Уже было продемонстрировано, что этот процесс отжига превосходит приблизительный отжиг при равновесном парциальном давлении с использованием Cd 1− y Zn.y в качестве источника отжига. Источник: IOPscience Для получения дополнительной информации посетите наш веб-сайт: www.semiconductorwafers.net , отправьте нам электронное письмо по адресу sales...
прочитайте большеВ этом исследовании слой InP был перенесен на подложку Si.покрытый термическим оксидом в процессе, сочетающем процесс ионной резки и селективное химическое травление. По сравнению с обычной ионной резкой объемных пластин InP, эта схема переноса слоев не только использует преимущества ионной резки, сохраняя оставшиеся подложки для повторного использования, но также использует преимущества селективного травления для улучшения состояния переносимой поверхности без использования химических и механических воздействий. полировка. Первоначально выращенная методом MOCVD гетероструктура InP/InGaAs/InP была имплантирована ионами H+. Имплантированная гетероструктура приклеивалась к кремниевой пластине, покрытой термическим слоем SiO2. При последующем отжиге связанная структура отслоилась на глубине вокруг проекции водорода, расположенной в подложке InP. Атомно-силовая микроскопия показала, что после селективного химического травления перенесенной структуры Источник: IOPscience Для получения допол...
прочитайте большеМы рассматриваем наши недавние усилия по разработке инфракрасных материалов HgCdSe на GaSb.подложки с помощью молекулярно-лучевой эпитаксии (MBE) для изготовления инфракрасных детекторов следующего поколения с характеристиками более низкой стоимости производства и большего размера матрицы в фокальной плоскости. Чтобы получить высококачественные эпитаксиальные слои HgCdSe, буферные слои ZnTe выращивают до выращивания HgCdSe, и исследование деформации несоответствия в буферных слоях ZnTe показывает, что толщина буферного слоя ZnTe должна быть ниже 300 нм, чтобы свести к минимуму образование несоответствующие вывихи. Длина волны отсечки/состав сплава материалов HgCdSe можно варьировать в широком диапазоне, изменяя отношение эквивалентного давления пучка Se/Cd во время выращивания HgCdSe. Температура роста оказывает значительное влияние на качество материала HgCdSe, а более низкая температура роста приводит к более высокому качеству материала для HgCdSe. Обычно длинноволновый инфракрасный ...
прочитайте большеМокрое травление является важным этапом в производстве полупроводниковых и солнечных пластин, а также в производстве устройств MEMS. Хотя он был заменен более точной технологией сухого травления в производстве передовых полупроводниковых устройств, он по-прежнему играет важную роль в производстве самой кремниевой подложки. Он также используется для снятия напряжения и текстурирования поверхности солнечных пластин в больших объемах. Будет рассмотрена технология влажного травления кремния для полупроводников и солнечных батарей. Влияние на этот шаг для пластиныбудут представлены свойства и критические параметры (плоскостность, топология и шероховатость поверхности для полупроводниковых пластин, текстура поверхности и коэффициент отражения для солнечных пластин). Будет представлено обоснование использования технологии травления и травителя для конкретных применений в производстве полупроводников и солнечных пластин. Источник: IOPscience Для получения дополнительной информации посетите наш...
прочитайте большеГомоэпитаксиальные пленки 4H-SiC были выращены на пористых гранях 4H-SiC (0001) с отклонением от оси 8° в диапазоне температур методом химического осаждения из газовой фазы из прекурсора бис(триметилсилил)метана (BTMSM). Энергия активации роста составила 5,6 ккал/моль, что указывает на то, что в росте пленки преобладает механизм, ограниченный диффузией. Треугольные дефекты упаковки были внедрены в тонкую пленку SiC, выращенную при низкой температуре 1280°C, за счет образования политипа 3C-SiC. Кроме того, в пленке SiC, выращенной ниже 1320°C, серьезно проявились сверхвинтовые дислокации. Чистая и невыразительная морфология наблюдалась в пленке SiC, выращенной со скоростью менее 25 стандартных кубических сантиметров в минуту (sccm). скорость потока газа-носителя BTMSM при 1380°C, в то время как политип 3C-SiC с двойными позиционными границами увеличивался при скорости потока 30 см3/мин BTMSM. На плотность дислокаций в эпислое сильно влияли температура роста и скор...
прочитайте большеВ течение последнего десятилетия использование слоев и структур из монокристаллического германия (Ge) в сочетании с подложками из кремния (Si) привело к возрождению исследований дефектов Ge. В кристаллах Si легирующие примеси и напряжения влияют на параметры собственных точечных дефектов (вакансии V и собственных междоузлий I ) и, таким образом, изменяют термические равновесные концентрации V и I . Однако управление концентрацией собственных точечных дефектов в кристаллах Ge пока не реализовано на том же уровне, что и в кристаллах Si, из-за отсутствия экспериментальных данных. В этом исследовании мы использовали расчеты теории функционала плотности (DFT) для оценки влияния изотропного внутреннего/внешнего напряжения ( σin / σ ex ) на энтальпию образования ( H f ) нейтральных V и I вокруг атома легирующей примеси (B, Ga, C, Sn и Sb) в Ge и сравнили результаты с результатами для Si. Результаты анализа тройные. Во-первых, H f V ( I ) в совершенном Ge уменьшается (увеличивается) на сжатие ...
прочитайте большеWafer Foundry: 26321#, Liamei Rd. Lianhua Industrial Area, Tong an, Xiamen 361100, China
 Контактная информация
Контактная информация luna@powerwaywafer.com
luna@powerwaywafer.com powerwaymaterial@gmail.com
powerwaymaterial@gmail.com  +86-592-5601 404
+86-592-5601 404













